光刻膠(Photoresist簡稱PR)又稱光致抗蝕劑,它是一種對光敏感的有機化合物,它受紫外光曝光后,在顯影液的溶解度會發生變化。
①光刻膠作用:將掩膜板上的圖形轉移到晶圓表面頂層的光刻膠中;在后續工序中,保護下面的材料(刻蝕或離子注入)。
②光刻膠的成分
樹脂:光刻樹脂是一種惰性的聚合物基質,是用來將其他材料聚合在一起的粘合劑。光刻膠的粘附性、膠膜厚度等都是樹脂給的。
感光劑:感光劑是光刻膠的核心部分,他對光形式的輻射能,特別在紫外區會發生反應。曝光時間、光源所發射光線的強度都根據感光劑的特性選擇決定的。
溶劑:光刻膠中容量最大的成分,感光劑和添加劑都是固體物質,為了方便均勻的涂覆,要將他們加入溶劑進行溶解,形成液態物質,并且使之具有良好的流動性,可以通過選擇方式涂布在wafer表面。
添加劑:用以改變光刻膠的某些特性,如改善光刻膠發生反射而添加染色劑。
③光刻膠的主要技術參數
分辨率:是指光刻膠可再現圖形的最小尺寸。
對比度:指光刻膠從曝光區到非曝光區過渡的陡度。
敏感度:光刻膠上產生一個良好的圖形所需一定波長光的最小能力值(或最小曝光量)。
粘滯性/黏度:衡量光刻膠流動特性參數。光刻膠中的溶劑揮發會使粘滯性增加。
粘附性:是指光刻膠與晶圓之間的粘著強度。
抗蝕性:光刻膠黏膜必須保持它的粘附性,并在后續的濕刻和干刻中保護襯體表面,這種性質被稱為抗蝕性。
表面張力:液體中將表面分子拉向液體主體內分子間的吸引了。
④光刻膠的分類
根據光刻膠按照如何響應紫外光的特性可以分為兩類:
正膠:曝光前對顯影液不可溶,而曝光后變成了可溶的,能得到與掩膜板遮光區相同的圖形。
負膠:反之
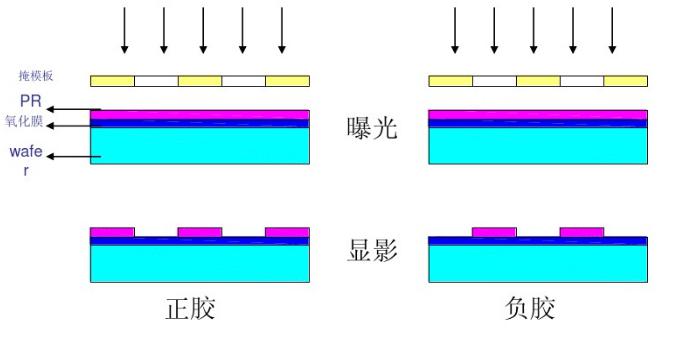
正膠與負膠優缺點:

根據光刻膠能形成圖形的最小光刻尺寸來分:
傳統光刻膠(正膠和負膠)
適用于紫外光(UV),I線365nm、H線405nm和G線436nm,關鍵尺寸在0.35um及其以上。
化學放大光刻膠(CAR)
適用于深紫外光(DUV),KrF準分子激光248nm和Arf準分子激光193nm。
⑤光刻膠的主要應用領域
模擬半導體、發光二極管(LED)、微電子機械系統(MEMS)、太陽能光伏、微流道和生物芯片、光電子器件/光子器件、封裝
⑥光刻工藝流程

⑦光刻質量要求
光刻的質量直接影響到器件的性能,成品率和可靠性。
1.圖形完整性好
2.尺寸準確
3.邊緣整齊,線條陡直
4.圖形內無針孔,圖形外無小島
5.硅片表面清潔,無底膜
6.圖形套刻準確


